IC产品的质量与牢靠性测验授权转载自【2018.01.19AA探针台阅读5654】
质量(Quality)和牢靠性(Reliability)在必定程度上能够说是IC产品的生命。质量(Quality)就是产品功能的丈量,它答复了一个产品是否契合规范(SPEC)的要求,是否契合各项功能指标的问题;牢靠性(Reliability)则是对产品耐久力的丈量,它答复了一个产品生命周期有多长,简略说,它能用多久的问题。所以说质量(Quality)处理的是现阶段的问题,牢靠性(Reliability)处理的是一段时刻以后的问题。知道了两者的差异,我们发现,Quality的问题处理办法往往比较直接,规划和制作单位在产品出产出来后,经过简略的测验,就能够知道产品的功能是否到达SPEC的要求,这种测验在IC的规划和制作单位就能够进行。相对而言,Reliability的问题似乎就变的非常扎手,这个产品能用多久,谁会能确保今天产品能用,明天就必定能用?
为了处理这个问题,人们制定了各种各样的规范,如:JESD22-A108-A、EIAJED-4701-D101,注:JEDEC(JointElectronDeviceEngineeringCouncil)电子设备工程联合委员会,闻名世界电子行业规范化安排之一;EIAJED:日本电子工业协会,闻名世界电子行业规范化安排之一。
在介绍一些现在较为盛行的Reliability的测验办法之前,我们先来认识一下IC产品的生命周期。典型的IC产品的生命周期能够用一条浴缸曲线(BathtubCurve)来表示。
 Region(I)被称为早夭期(Infancyperiod)
Region(I)被称为早夭期(Infancyperiod)
这个阶段产品的failurerate快速下降,形成失效的原因在于IC规划和出产进程中的缺点;
Region(II)被称为运用期(Usefullifeperiod)
在这个阶段产品的failurerate坚持稳定,失效的原因往往是随机的,比如温度改变等等;
Region(III)被称为磨耗期(Wear-Outperiod)
在这个阶段failurerate会快速升高,失效的原因就是产品的长期运用所形成的老化等。
认识了典型IC产品的生命周期,我们就能够看到,Reliability的问题就是要力求将处于早夭期failure的产品去除并预算其良率,预计产品的运用期,而且找到failure的原因,尤其是在IC出产,封装,存储等方面呈现的问题所形成的失效原因。
下面就是一些IC产品牢靠性等级测验项目(ICProductLevelreliabilitytestitems)
一、运用寿命测验项目(Lifetestitems):EFR,OLT(HTOL),LTOL
①EFR:早期失效等级测验(EarlyfailRateTest)
意图:评价工艺的稳定性,加快缺点失效率,去除因为天生原因失效的产品。
测验条件:在特定时刻内动态提升温度和电压对产品进行测验
失效机制:资料或工艺的缺点,包含诸如氧化层缺点,金属刻镀,离子玷污等因为出产形成的失效。
详细的测验条件和预算成果可参阅以下规范:JESD22-A108-A;EIAJED-4701-D101。
②HTOL/LTOL:高/低温操作生命期实验(High/LowTemperatureOperatingLife)
意图:评价器材在超热和超电压状况下一段时刻的耐久力
测验条件:125℃,1.1VCC,动态测验
失效机制:电子搬迁,氧化层破裂,相互分散,不稳定性,离子玷污等
参阅规范:
125℃条件下1000小时测验经过IC能够确坚持续运用4年,2000小时测验持续运用8年;
150℃1000小时测验经过确保运用8年,2000小时确保运用28年。
详细的测验条件和预算成果可参阅以下规范:MIT-STD-883EMethod1005.8;JESD22-A108-A;EIAJED-4701-D101。
二、环境测验项目(Environmentaltestitems)
PRE-CON,THB,HAST,PCT,TCT,TST,HTST,SolderabilityTest,SolderHeatTest
①PRE-CON:预处理测验(PreconditionTest)
意图:模拟IC在运用之前在必定湿度,温度条件下存储的耐久力,也就是IC从出产到运用之间存储的牢靠性。
测验流程(TestFlow):
Step1:超声扫描仪SAM(ScanningAcousticMicroscopy)
Step2:高低温循环(Temperaturecycling)
-40℃(orlower)~60℃(orhigher)for5cyclestosimulateshippingconditions
Step3:烘烤(Baking)
Atminimum125℃for24hourstoremoveallmoisturefromthepackage
Step4:浸泡(Soaking)
Usingoneoffollowingsoakconditions
-Level1:85℃/85%RHfor168hrs(储运时刻多久都没关系)
-Level2:85℃/60%RHfor168hrs(储运时刻一年左右)
-Level3:30℃/60%RHfor192hrs(储运时刻一周左右)
Step5:Reflow(回流焊)
240℃(-5℃)/225℃(-5℃)for3times(Pb-Sn)
245℃(-5℃)/250℃(-5℃)for3times(Lead-free)
*chooseaccordingthepackagesize
Step6:超声扫描仪SAM(ScanningAcousticMicroscopy)
 BGA在回流工艺中因为湿度原因而过度胀大所导致的分层/裂纹
BGA在回流工艺中因为湿度原因而过度胀大所导致的分层/裂纹
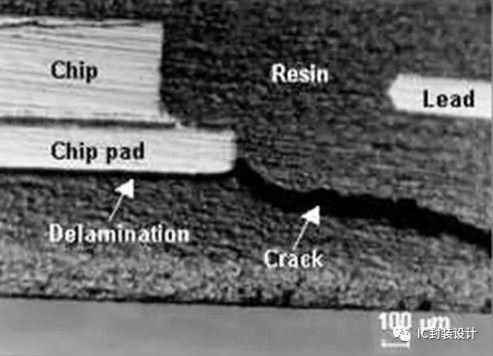 封装破裂,分层
封装破裂,分层
详细的测验条件和预算成果可参阅以下规范:JESD22-A113-D;EIAJED-4701-B101。
评价成果:八种耐湿润分级和车间寿命(floorlife),请参阅J-STD-020。
 注:对于6级,元件运用之前有必要经过烘焙,而且有必要在湿润灵敏注意标贴上所规则的时刻限定内回流。
注:对于6级,元件运用之前有必要经过烘焙,而且有必要在湿润灵敏注意标贴上所规则的时刻限定内回流。
提示:湿度总是困扰在电子体系背面的一个难题。不管是在空气流通的热带区域中,还是在湿润的区域中运送,湿润都是显著添加电子工业开支的原因。因为湿润灵敏性元件运用的添加,诸如薄的密距离元件(fine-pitchdevice)和球栅阵列(BGA,ballgridarray),使得对这个失效机制的关注也添加了。基于此原因,电子制作商们有必要为预防潜在灾难支付昂扬的开支。吸收到内部的潮气是半导体封装最大的问题。当其固定到PCB板上时,回流焊快速加热将在内部形成压力。这种高速胀大,取决于不同封装结构资料的热胀大系数(CTE)速率不同,可能产生封装所不能承受的压力。当元件暴露在回流焊接期间升高的温度环境下,陷于塑料的外表贴装元件(SMD,surfacemountdevice)内部的湿润会产生满足的蒸汽压力损害或毁坏元件。常见的失效形式包含塑料从芯片或引脚框上的内部分离(脱层)、金线焊接损害、芯片损害、和不会延伸到元件外表的内部裂纹等。在一些极点的状况中,裂纹会延伸到元件的外表;最严峻的状况就是元件鼓胀和爆裂(叫做"爆米花"效益)。尽管现在,进行回流焊操作时,在180℃~200℃时少量的湿度是能够接受的。然而,在230℃~260℃的范围中的无铅工艺里,任何湿度的存在都能够形成满足导致破坏封装的小爆破(爆米花状)或资料分层。有必要进行正确的封装资料挑选、仔细操控的组装环境和在运送中选用密封包装及放置干燥剂等措施。实际上国外常常运用装备有射频标签的湿度跟踪体系、局部操控单元和专用软件来显现封装、测验流水线、运送/操作及组装操作中的湿度操控。
②THB:加快式温湿度及偏压测验(TemperatureHumidityBiasTest)
意图:评价IC产品在高温,高湿,偏压条件下对湿气的反抗能力,加快其失效进程。
测验条件:85℃,85%RH,1.1VCC,Staticbias
失效机制:电解腐蚀
详细的测验条件和预算成果可参阅以下规范:JESD22-A101-D;EIAJED-4701-D122
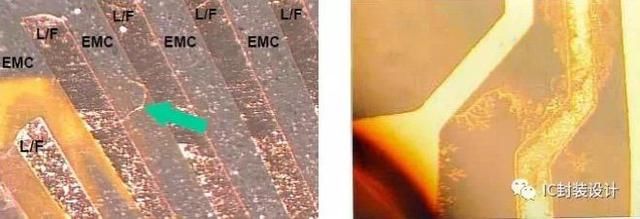 Leakagefailure
Leakagefailure
③高加快温湿度及偏压测验(HAST:HighlyAcceleratedStressTest)
意图:评价IC产品在偏压下高温,高湿,高气压条件下对湿度的反抗能力,加快其失效进程。
测验条件:130℃,85%RH,1.1VCC,Staticbias,2.3atm
失效机制:电离腐蚀,封装密封性
详细的测验条件和预算成果可参阅以下规范:JESD22-A110
 AuWireBallBondwithKirkendallVoiding
AuWireBallBondwithKirkendallVoiding
④PCT:高压蒸煮实验PressureCookTest(AutoclaveTest)
意图:评价IC产品在高温,高湿,高气压条件下对湿度的反抗能力,加快其失效进程。
测验条件:130℃,85%RH,Staticbias,15PSIG(2atm)
失效机制:化学金属腐蚀,封装密封性
详细的测验条件和预算成果可参阅以下规范:JESD22-A102;EIAJED-4701-B123
*HAST与THB的差异在于温度更高,而且考虑到压力因素,实验时刻能够缩短,而PCT则不加偏压,但湿度增大。
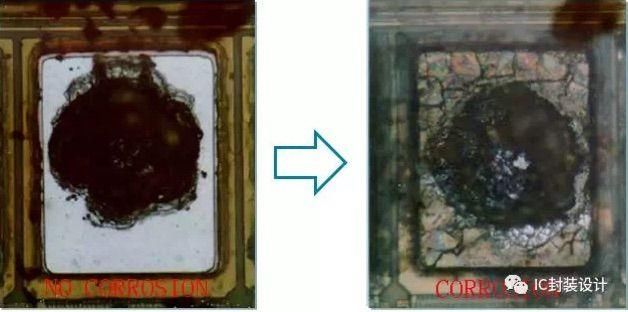 Bondpadcorrosion
Bondpadcorrosion
⑤TCT:高低温循环实验(TemperatureCyclingTest)
意图:评价IC产品中具有不同热胀大系数的金属之间的界面的触摸良率。办法是经过循环流动的空气从高温到低温重复改变。
测验条件:
ConditionB:-55℃to125℃
ConditionC:-65℃to150℃
失效机制:电介质的开裂,导体和绝缘体的开裂,不同界面的分层
详细的测验条件和预算成果可参阅以下规范:MIT-STD-883EMethod1010.7;JESD22-A104-A;EIAJED-4701-B-131
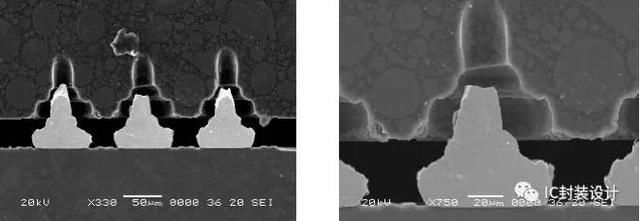 Ballneckbrokenbydietopde-laminationafterTempcycling
Ballneckbrokenbydietopde-laminationafterTempcycling
⑥TST:高低温冲击实验(ThermalShockTest)
意图:评价IC产品中具有不同热胀大系数的金属之间的界面的触摸良率。办法是经过循环流动的液体从高温到低温重复改变。
测验条件:
ConditionB:-55℃to125℃
ConditionC:-65℃to150℃
失效机制:电介质的开裂,资料的老化(如bondwires),导体机械变形
详细的测验条件和预算成果可参阅以下规范:MIT-STD-883EMethod1011.9;JESD22-B106;EIAJED-4701-B-141
*TCT与TST的差异在于TCT偏重于package的测验,而TST偏重于晶园的测验
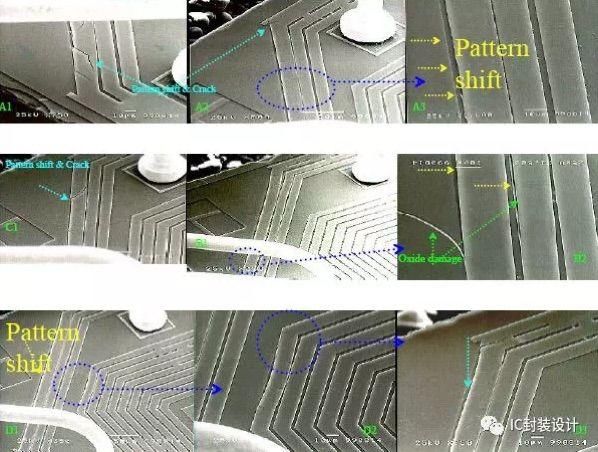 MetalcrackandmetalshiftafterthermalShock
MetalcrackandmetalshiftafterthermalShock
⑦HTST:高温贮存实验(HighTemperatureStorageLifeTest)
意图:评价IC产品在实际运用之前在高温条件下坚持几年不工作条件下的生命时刻。
测验条件:150℃
失效机制:化学和分散效应,Au-Al共金效应
详细的测验条件和预算成果可参阅以下规范:MIT-STD-883EMethod1008.2;JESD22-A103-A;EIAJED-4701-B111
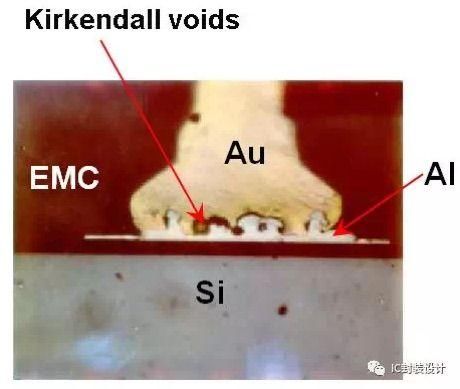 KirkendallVoid
KirkendallVoid
⑧可焊性实验(SolderabilityTest)
意图:评价ICleads在粘锡进程中的牢靠度
测验办法:
Step1:蒸汽老化8小时
Step2:浸入245℃锡盆中5秒
失效规范(FailureCriterion):至少95%良率
详细的测验条件和预算成果可参阅以下规范:MIT-STD-883EMethod2003.7;JESD22-B102。
 poorsolderabilityofthepadsurface
poorsolderabilityofthepadsurface
⑨SHTTest:焊接热量耐久测验(SolderHeatResistivityTest)
意图:评价IC对瞬间高温的灵敏度
测验办法:侵入260℃锡盆中10秒
失效规范(FailureCriterion):依据电测验成果
详细的测验条件和预算成果可参阅以下规范:MIT-STD-883EMethod2003.7;EIAJED-4701-B106。
三、耐久性测验项目(Endurancetestitems)
Endurancecyclingtest,Dataretentiontest
①周期耐久性测验(EnduranceCyclingTest)
意图:评价非挥发性memory器材在多次读写算后的持久功能
测验办法:将数据写入memory的存储单元,在擦除数据,重复这个进程多次
测验条件:室温,或者更高,每个数据的读写次数到达100k~1000k
详细的测验条件和预算成果可参阅以下规范:MIT-STD-883EMethod1033
②数据坚持力测验(DataRetentionTest)
意图:在重复读写之后加快非挥发性memory器材存储节点的电荷丢失
测验办法:在高温条件下将数据写入memory存储单元后,多次读取验证单元中的数据
测验条件:150℃
详细的测验条件和预算成果可参阅以下规范:MIT-STD-883EMethod1008.2;MIT-STD-883EMethod1033
在了解上述的IC测验办法之后,IC的规划制作商就需求依据不必IC产品的功能,用处以及需求测验的意图,挑选合适的测验办法,最大限度的降低IC测验的时刻和本钱,从而有效操控IC产品的质量和牢靠度。
各位小主,好消息来了!由闻名导演江小鱼执导的以青春校园为体裁院线电影《别来无恙》定于近期开机拍照,导演组决定在全国征集最美学妹,获胜者将作为主要演员来参演《别来无恙》。

 电话
电话 邮箱
邮箱 北京市房山区良乡凯旋大街建设路18号-D4857
北京市房山区良乡凯旋大街建设路18号-D4857